01
Einführung
Das Zerteilen von Wafern ist ein wichtiger Teil der Herstellung von Halbleiterbauelementen. Die Methode und Qualität des Würfelns wirken sich direkt auf die Dicke, Rauheit, Abmessungen und Produktionskosten des Wafers aus und haben erhebliche Auswirkungen auf die Geräteherstellung. Siliziumkarbid ist als Halbleitermaterial der dritten-Generation ein wichtiges Material, das die elektrische Revolution vorantreibt. Die Produktionskosten für qualitativ hochwertiges kristallines Siliziumkarbid sind extrem hoch, und die Menschen hoffen im Allgemeinen, einen großen Siliziumkarbidbarren in möglichst viele dünne Siliziumkarbid-Wafersubstrate schneiden zu können. Gleichzeitig hat das Wachstum der Branche zu immer größeren Wafergrößen geführt, was die Anforderungen an die Dicing-Prozesse erhöht hat. Allerdings ist Siliziumkarbid mit einer Mohs-Härte von 9,5 extrem hart und liegt damit hinter Diamant (10) an zweiter Stelle. Außerdem ist es spröde, was das Schneiden erschwert. Derzeit verwenden industrielle Verfahren im Allgemeinen das Sägen mit Schlammdraht oder Diamantdraht. Während des Schneidens werden feststehende Drahtsägen in gleichmäßigen Abständen um den Siliziumkarbid-Ingot gelegt, und der Ingot wird mit gespannten Drahtsägen geschnitten. Mit der Drahtsägemethode dauert das Trennen von Wafern aus einem Barren mit 6 Zoll Durchmesser etwa 100 Stunden. Die resultierenden Wafer weisen relativ breite Schnittfugen, rauere Oberflächen und Materialverluste von bis zu 46 % auf. Dies erhöht die Kosten für die Verwendung von Siliziumkarbid-Materialien und schränkt ihre Entwicklung in der Halbleiterindustrie ein, was den dringenden Bedarf an Forschung zu neuen Siliziumkarbid-Wafer-Dicing-Technologien verdeutlicht.
In den letzten Jahren erfreut sich der Einsatz der Laserschneidtechnologie bei der Herstellung von Halbleitermaterialien immer größerer Beliebtheit. Bei dieser Methode wird ein fokussierter Laserstrahl verwendet, um die Oberfläche oder das Innere des Materials zu verändern und es so zu trennen. Da es sich um ein berührungsloses Verfahren handelt, werden Werkzeugverschleiß und mechanische Beanspruchung vermieden. Dadurch werden die Rauheit und Präzision der Waferoberfläche erheblich verbessert, nachfolgende Polierprozesse überflüssig gemacht, der Materialverlust reduziert, die Kosten gesenkt und die durch herkömmliches Schleifen und Polieren verursachte Umweltverschmutzung minimiert. Die Laserschneidtechnologie wird seit langem zum Würfeln von Siliziumblöcken eingesetzt, ihre Anwendung im Bereich Siliziumkarbid ist jedoch noch unausgereift. Derzeit gibt es mehrere Haupttechniken.
02
Wasser-Geführtes Laserschneiden
Die wassergeführte Lasertechnologie (Laser MicroJet, LMJ), auch bekannt als Laser-Mikro-Jet-Technologie, basiert auf dem Prinzip der Fokussierung eines Laserstrahls auf eine Düse, während dieser durch eine druckmodulierte Wasserkammer läuft. Aus der Düse wird ein Wasserstrahl mit niedrigem-Druck ausgestoßen, und aufgrund des Unterschieds im Brechungsindex an der Wasser-Luft-Grenzfläche wird ein Lichtwellenleiter gebildet, der es dem Laser ermöglicht, sich entlang der Richtung des Wasserflusses auszubreiten. Dadurch wird ein Wasserstrahl mit hohem Druck geleitet, um die Materialoberfläche zu bearbeiten und zu schneiden. Der Hauptvorteil des wassergeführten Laserschneidens liegt in seiner Schnittqualität. Der Wasserstrom kühlt nicht nur den Schneidbereich, wodurch thermische Verformungen und thermische Schäden am Material reduziert werden, sondern entfernt auch Bearbeitungsrückstände. Im Vergleich zum Drahtsägenschneiden ist es deutlich schneller. Da Wasser jedoch unterschiedliche Laserwellenlängen in unterschiedlichem Maße absorbiert, ist die Laserwellenlänge begrenzt, hauptsächlich auf 1064 nm, 532 nm und 355 nm.
1993 schlug der Schweizer Wissenschaftler Beruold Richerzhagen diese Technologie erstmals vor. Er gründete Synova, ein Unternehmen, das sich der Forschung, Entwicklung und Kommerzialisierung der wassergeführten Lasertechnologie widmet und international führend ist. Die inländische Technologie ist relativ zurückgeblieben, aber Unternehmen wie Innolight und Shengguang Silicon Research entwickeln sie aktiv weiter.
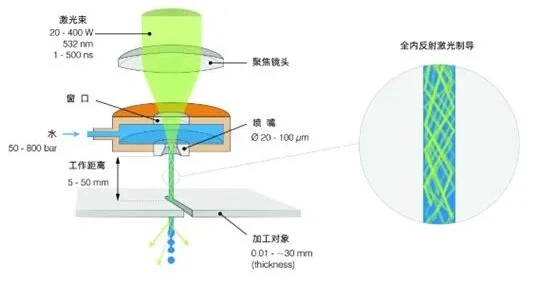
03
Stealth-Würfeln
Stealth Dicing (SD) ist eine Technik, bei der ein Laser durch die Oberfläche eines Siliziumkarbid-Wafers fokussiert wird, um eine modifizierte Schicht in der gewünschten Tiefe zu bilden und so die Wafer-Trennung zu ermöglichen. Da es keine Schnitte auf der Waferoberfläche gibt, kann eine höhere Bearbeitungspräzision erreicht werden. Das SD-Verfahren mit Nanosekunden-Pulslasern wird bereits industriell zur Trennung von Siliziumwafern eingesetzt. Bei der SD-Bearbeitung von Siliziumkarbid durch Nanosekunden-Pulslaser ist die Impulsdauer jedoch viel länger als die Kopplungszeit zwischen Elektronen und Phononen in Siliziumkarbid (im Pikosekundenbereich), was zu thermischen Effekten führt. Der hohe Wärmeeintrag auf den Wafer macht die Trennung nicht nur anfällig für Abweichungen von der gewünschten Richtung, sondern erzeugt auch erhebliche Restspannungen, die zu Brüchen und schlechter Spaltung führen. Daher werden beim SD-Prozess bei der Bearbeitung von Siliziumkarbid typischerweise Ultrakurzpulslaser eingesetzt, wodurch thermische Effekte stark reduziert werden.

Das japanische Unternehmen DISCO hat eine Laserschneidtechnologie namens Key Amorphous-Black Repetitive Absorption (KABRA) entwickelt. Beispielsweise konnte bei der Verarbeitung von Siliziumkarbid-Ingots mit einem Durchmesser von 6 Zoll und einer Dicke von 20 mm die Produktivität von Siliziumkarbid-Wafern vervierfacht werden. Der KABRA-Prozess fokussiert den Laser im Wesentlichen im Inneren des Siliziumkarbidmaterials. Durch die „amorph-schwarze repetitive Absorption“ wird das Siliziumkarbid in amorphes Silizium und amorphen Kohlenstoff zerlegt und bildet eine Schicht, die als Wafer-Trennpunkt dient, die sogenannte schwarze amorphe Schicht, die mehr Licht absorbiert und die Trennung der Wafer erheblich erleichtert.

Die von Siltectra, das von Infineon übernommen wurde, entwickelte Cold-Split-Wafer-Technologie kann nicht nur verschiedene Arten von Ingots in Wafer aufteilen, sondern reduziert auch den Materialverlust um bis zu 90 %, wobei jeder Wafer nur 80 µm verliert, was letztendlich die Gesamtkosten für die Geräteproduktion um bis zu 30 % senkt. Die Cold-Split-Technologie umfasst zwei Schritte: Zuerst bestrahlt ein Laser den Barren, um eine Delaminierungsschicht zu erzeugen, die zu einer inneren Volumenausdehnung im Siliziumkarbidmaterial führt, die Zugspannung erzeugt und einen sehr schmalen Mikroriss bildet; Anschließend verwandelt ein Polymerabkühlungsschritt den Mikroriss in einen Hauptriss und trennt schließlich den Wafer vom verbleibenden Barren. Im Jahr 2019 evaluierte ein Dritter diese Technologie und maß die Oberflächenrauheit Ra der geteilten Wafer mit weniger als 3 µm, wobei die besten Ergebnisse bei weniger als 2 µm lagen.

Das vom chinesischen Unternehmen Han's Laser entwickelte modifizierte Laser-Dicing ist eine Lasertechnologie, mit der Halbleiterwafer in einzelne Chips oder Dies getrennt werden. Bei diesem Verfahren wird auch ein präziser Laserstrahl verwendet, um den Wafer zu scannen und eine modifizierte Schicht innerhalb des Wafers zu bilden, wodurch der Wafer unter angelegter Spannung entlang des Laserscanpfads reißen kann, wodurch eine präzise Trennung erreicht wird.
Abbildung 5. Modifizierter Laser-Dicing-Prozessablauf
Derzeit beherrschen inländische Hersteller die auf Slurry--basierte Siliziumkarbid-Dicing-Technologie. Das Zerteilen mit Schlamm verursacht jedoch einen hohen Materialverlust, einen geringen Wirkungsgrad und eine starke Umweltverschmutzung und wird nach und nach durch die Diamantdraht-Würfeltechnologie ersetzt. Gleichzeitig zeichnet sich das Laser-Dicing durch seine Leistungs- und Effizienzvorteile aus. Im Vergleich zu herkömmlichen mechanischen Kontaktverarbeitungstechnologien bietet es viele Vorteile, darunter eine hohe Verarbeitungseffizienz, schmale Ritzlinien und eine hohe Schnittfugendichte, was es zu einem starken Konkurrenten für den Ersatz des Diamantdrahtschneidens macht. Es eröffnet einen neuen Weg für die Anwendung von Halbleitermaterialien der nächsten-Generation wie Siliziumkarbid. Mit der Weiterentwicklung der Industrietechnologie und der kontinuierlichen Zunahme der Siliziumkarbid-Substratgrößen wird sich die Siliziumkarbid-Dicing-Technologie rasant weiterentwickeln, und effizientes, qualitativ hochwertiges Laser-Dicing wird ein wichtiger Trend für das zukünftige Siliziumkarbid-Schneiden sein.









